SEM-EDX-ANALYTIK
Mikroskopische Untersuchung & Elementanalyse in einem Arbeitsschritt
SEM-EDX
Funktionsprinzip
Bei der Raster-Elektronenmikroskopie (SEM) wird ein fokussierter Primär-Elektronenstrahl punktweise über die Probe geführt. Die zurück gestreuten Elektronen werden in einem Detektor gezählt. Die Elektronenzahl je Bildpunkt ergibt ein mikroskopisches Abbild der Probe in Graustufen. Es gibt zwei bildgebende Verfahren:
Rückgestreute Elektronen (BE) → Material-Kontrast
Sekundäre Elektronen (SE) → Topographie-Kontrast
Zusätzlich regt der Primär-Elektronenstrahl die Probe zur Emission von charakteristischer Röntgenstrahlung an. Durch die Analyse des Farbspektrums in einem EDX-Detektor können die Elemente in der Probe und deren Gewichtsanteil präzise bestimmt werden.
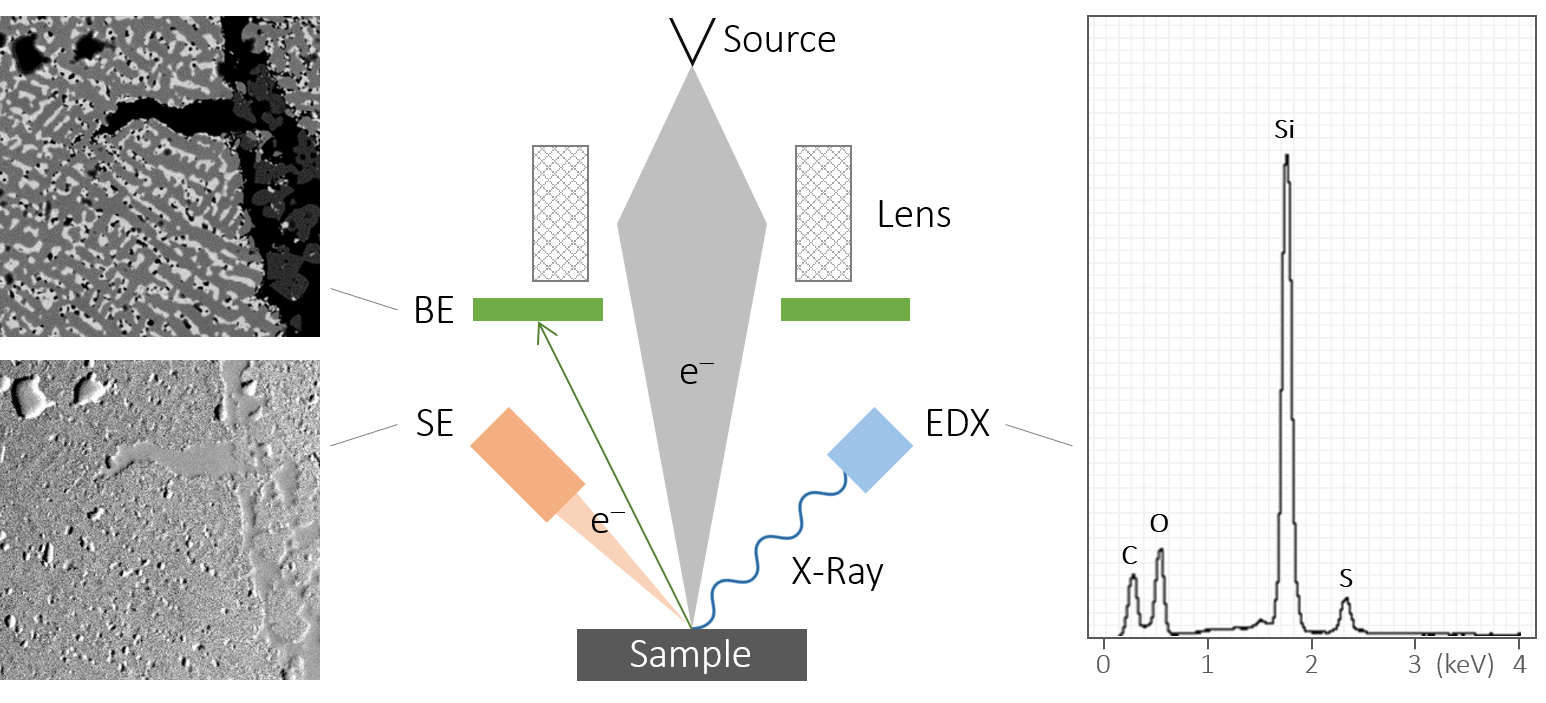
Anwendungsbeispiele
- Untersuchung von Schadensfällen und Verschleiss auf mikroskopischer Ebene
- Analyse von Alterung, Korrosion und Oxidation bei Bauteilen
- Herkunftsbestimmung der zum Ausfall führenden Partikel, Späne und Teilchen
- Fehleranalyse bei der Delamination von Beschichtungen und Lacken
- Untersuchung elektrischer Kontaktprobleme
- Analyse von Oberflächen und Vergütungen
- Werkstoffbestimmung und Gefügeanalyse
Bildergalerie

Strahlgut auf CN-Membrane

Abrasive Korund-Partikel

Aluminium-Span auf Siebgewebe

Akustik-Schaumstoff

Sandpartikel

Kontaminierte Glaspartikel