SEM-EDX ANALYSIS
Microscopic examination & elemental analysis in one step
SEM-EDX
Functional Principle in Focus
In scanning electron microscopy (SEM), a focused primary electron beam is rastered stepwise across the sample. At each pixel, the reflected electrons are detected, yielding a microscopic greyscale image of the sample. There are two imaging techniques:
Backscattered electrons (BE) → material contrast
Secondary electrons (SE) → topography contrast
In addition, the primary electron beam triggers the sample to emit characteristic X-Rays. The elements in the sample as well as their respective modal weights can be precisely determined by analyzing the color spectrum in an EDX detector.
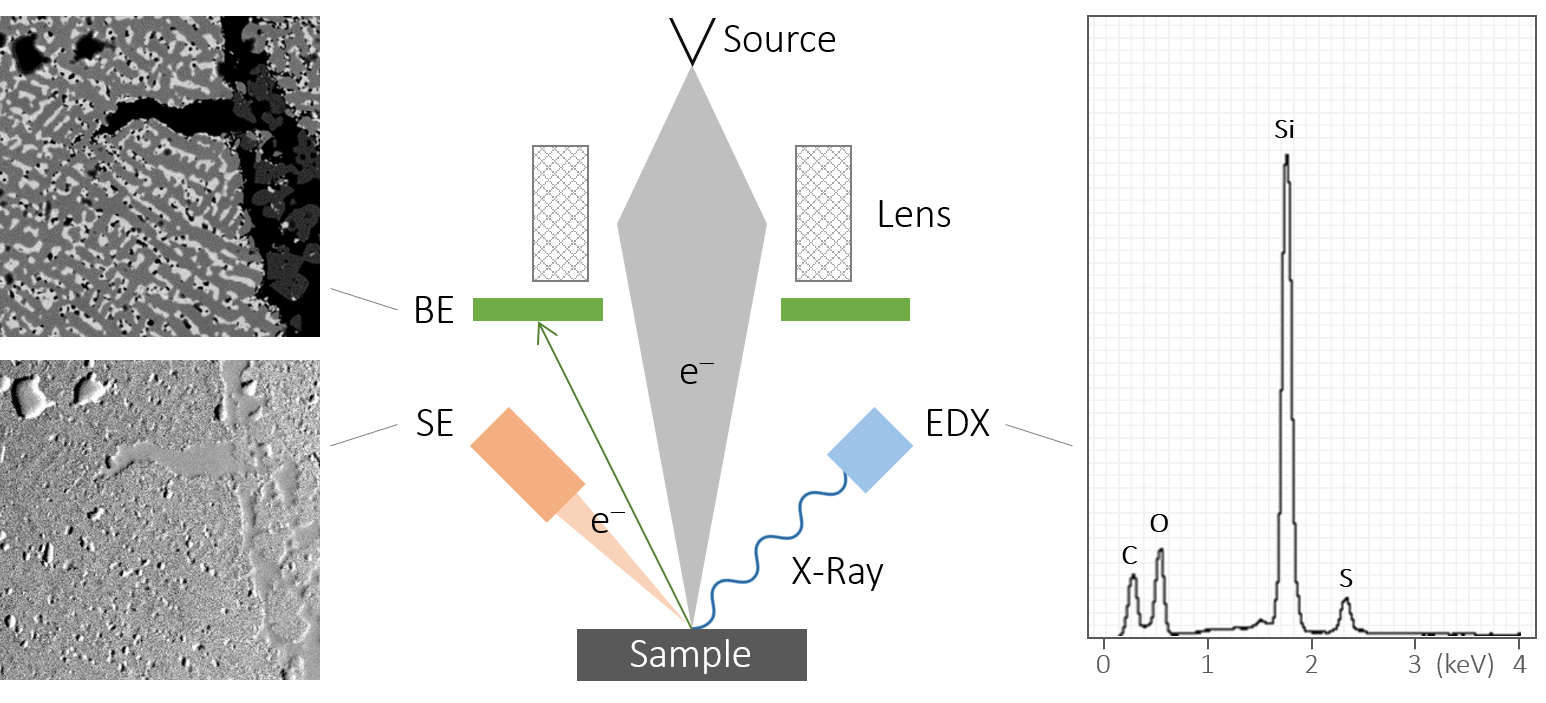
Applications
- Investigation of damage and wear on a microscopic level
- Analysis of aging, corrosion and oxidation of components
- Determination of the origin of the particles, chips and particles leading to failure
- Particle analysis for the determination of the technical cleanliness
- Analysis of non-metallic inclusions in steels and other metals
- Quality control of powders in Battery manufacturing and additive manufacturing
- Error analysis in the delamination of coatings and paints
- Investigation of electrical contact problems
- Analysis of surfaces and coatings
- Material determination and microstructural analysis
SEM photo gallery
Growth zones in feldspar (BE)
Diatom Microfossil (SE)
Bacterial lime deposits on wood (SE)
vegetable fiber (BE)
Coated Granules (BE)
Cosmetic Powder (BE)
Antenna of a bee (BE)
Diaphragm cross section (SE)
Monazite mineral (BE)
Cross-section of wood (SE)
Biofilm (SE)
Microstructured Aluminum (SE)
Filter membrane made of Al2O3 (SE)
Cat Brain Tissue (STEM)
Salt crystals in sugar matrix (BE)
steel balls (BE)
Nickel titanium cut (BE)
Charcoal (BE)
Inclusions in glass (BE)
Tin balls at 100kx (SE)
Video Tutorial
Scanning Electron Microscopy
Prof. Dr.-Ing. Rainer Schwab, University of Karlsruhe